31 Jul
ALD技术使GaN功率器件更高效!
氮化镓(GaN)由于其宽禁带特性而成为电力电子产品的优质材料。随着交通电气化,GaN功率器件变得越来越重要,器件成本和效率也随之成为了关键要素。对于许多应用而言,增强型或常闭模式器件对于故障安全要求是非常必要的,并且栅介电层(例如Al2O3)对于获得更高效的在增强型模式下工作的器件也是至关重要的。
以下是ALD技术使GaN功率器件增效的五个方面:膜质量 (Film Quality),一致性 (Conformality),可控性 (Control),低损伤 (Low Damage),预处理 (Pre-treatments)。
膜质量
氮化镓晶体管的栅极电介质薄膜必须高质量,才能降低电流的泄漏,从而产生更高的击穿电压。等离子增强ALD技术的优点是可以准确可靠地沉积致密层,从而优化器件性能。只有在高电压下才会发生击穿,而膜层具备高击穿电压的原因有两方面:膜层质量高,以及由于ALD填充空穴的能力而造成针孔缺陷水平低。有趣的是,这些特性只有在200-400°C的适度温度才可以产生,无需其他技术所需要的高温过程。
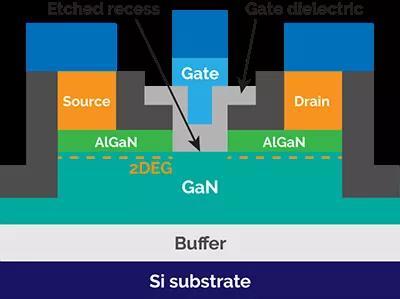
图1:具有刻蚀凹槽和连续栅介质结构的常闭型氮化硅-硅基功率装置的截面示意图。
一致性
凹槽结构对于许多定向沉积技术(比如溅射)都非常具有挑战性。而在氮化镓设备中用到的凹槽几何结构具有相对适中的高宽比,因此对于大多数ALD工艺来说是十分容易做到的。ALD工艺的独特性使得生长的膜层在整体器件结构中连续且厚度基本一致,且对高宽比变化不敏感,因此工艺窗口较大,一般不需要通过改变工艺菜单来保证沉积条件。
可控性
在生产及研究过程中,厚度和性能控制都是必不可少的。ALD的工艺独特性使其在大尺寸衬底沉积中具有优异的均匀性,从而使所有的器件都具有相同的性能。由于所得到的薄膜厚度是根据所选择的ALD循环数来确定的,具有良好的再现性,因此不管是不同机台之间,或者同一机台的不同时间都有非常好的沉积厚度重复性。ALD有着良好的阶梯覆盖特性,工艺菜单易于管理,相同腔室兼容多种材质沉积。这些特性使其符合未来材料改性和工艺改进的趋势。例如,使用更高介电材料(如二氧化铪)以及氮化电介质(如氮化铝)。
低损伤
在电子工业中,氮化镓与其他半导体相比是加工敏感性最高的材料之一。幸运的是,远程可控等离子ALD技术对氮化镓造成的损耗很低。优化工艺条件以及限制离子能量和通量能够使界面和薄膜产生较低的缺陷密度,与此同时,活性反应组分密度和通量足以生长高质量的膜层材料,并具备量产能力。
预处理
在ALD前序工艺中或者只是在空气中暴露后,氮化镓表面可能会产生低质量的表面氧化物,并可能含有缺陷和杂质,比如碳。远程可控等离子体脉冲和ALD前驱体脉冲都可以用来减少上述缺陷和杂质。三甲基铝(TMA)是一种常用于电介质氧化铝生长的ALD前驱体。有趣的是,TMA实际上可以作为还原剂去除氮化镓表面的一些氧化物。众所周知,氢和氮等离子体能够减少表面氧化物,并且能够去除杂质,比如碳。

图2:以氢或氮等离子体预处理以及氧化铝等离子ALD对氮化镓表面的影响为例,说明预处理和ALD对氮化镓表面组成和结构的影响。
ALD在功率半导体领域中应用广泛,以上5个方面只是冰山一角。如果将预处理和等离子ALD的后续处理方式(如退火)相结合,就有望进一步优化器件性能!如您有任何问题或者想法想要与我们交流,请发送邮件至China.info@oxinst.com或者拨打热线400-678-0609。



 公安机关备案号31010402003473
公安机关备案号31010402003473