有关: 半导体、微电子与数据存储
从样品制备、电气特性描述到物理分析。
通常有必要将这些纳米级电学响应与电子显微镜成像关联起来。例如,在设备故障分析中,必须对缺陷位置定位,以便随后对其进行隔离和深入表征。OmniProbe 纳米机械手系列可以实现上述操作。在接触 10nm 特征时,可以执行电子束感生电流(EBIC)和电子束吸收电流(EBAC)等电性能成像技术。
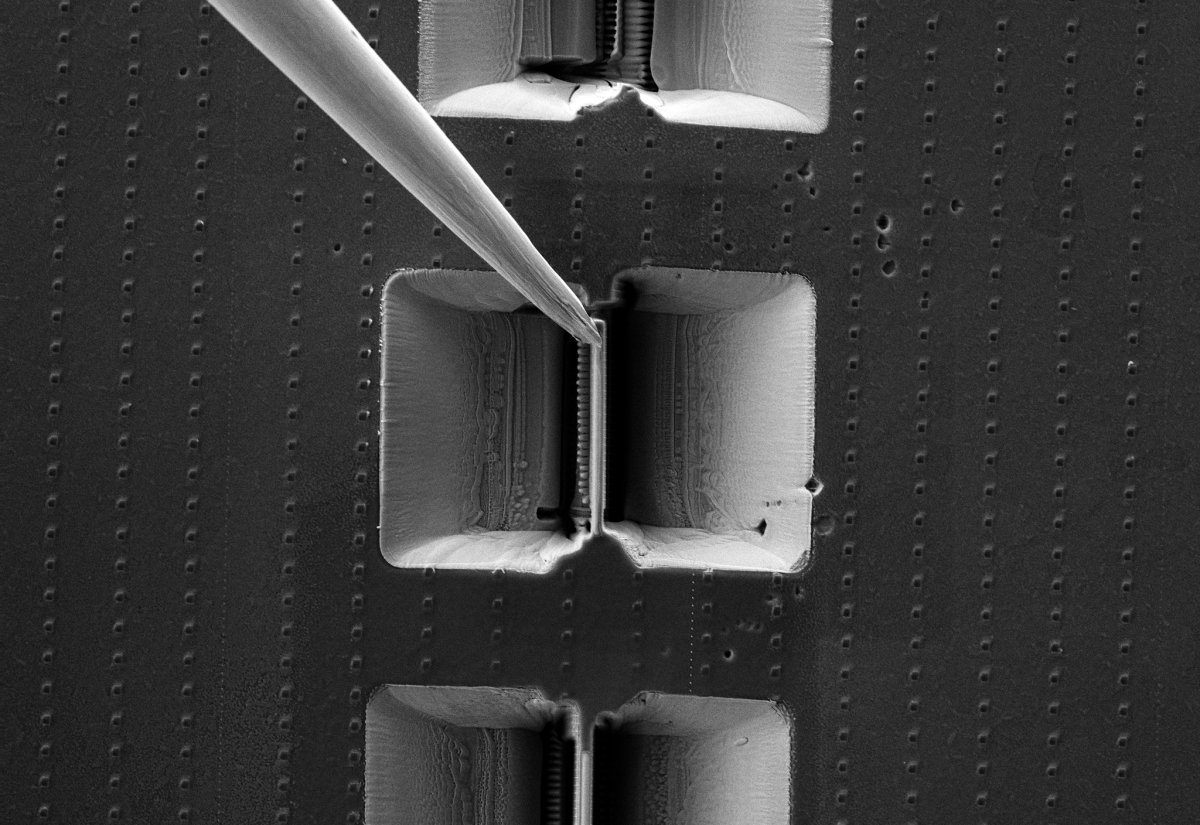
一旦发现故障并在器件上找出故障位置后,有必要取下该结构在其他仪器上(如透射电子显微镜等)进行进一步分析或在相同仪器(聚焦离子束)上达到更好的运行条件。半导体行业需求下,工艺应具有可重复性,分析每个样品的典型时间小于 30 分钟。器件向 3 或 5 纳米制程靠近时任务难度将进一步提高,因为要求试样厚度小于 20nm。OmniProbe 400 是实现所有这些压电驱动运动的理想工具,可以实现 10nm 量级的可重复定位;通过同心旋转功能可以轻松获得高级的制备几何设置,从而获得更高质量的样品。
还可以将 OmniProbe400 与 AZtec LayerProbe 搭配使用,同时进行顶出(lift-out)和局部厚度测量操作,从而实现真正的样本制备过程控制。
应用说明:高品质TEM的制备
下载应用说明
针对半导体器件的失效分析,金属化层必须暴露在外。器件中节点尺寸越来越小,架构三维度也越来越高,因此该操作的挑战性越来越强。我们的等离子辅助蚀刻工具可以精准去除氧化物、氮化物、多晶化合物等多种半导体化合物,不会提升或损坏金属化部分。我们灵活的 FA 工具对晶片进行逆向处理的速度比之前的工艺快 10 倍,确保更大产能和生产效率。
一旦发现故障设备并将其与晶片的其他部分隔离,开始检测故障根本原因的工作就开始了。故障的可能原因:工艺中的化学成分不一致、杂质颗粒或沉积材料晶体结构变化等。许多可能出现故障的地方都极其微小,通常只有几纳米。牛津仪器的 Ultim Extreme 能量色散 X 射线分光计(EDS)可以在扫描电子显微镜(SEM)可以胜任的各种环境下工作,且能形成分辨率 10nm 的批量器件元素信息。
在 TEM 中,我们的 X-Max TEM 通过 AZtecTEM 供电,以便在更高分辨率下完成准确度更高的定量分析。
应用说明:在SEM中形成器件图像
下载应用说明应用说明:在TEM中形成图像
下载应用说明并非所有的器件失效都由化学原因导致。有些是由于沉积材料的结构或相导致的。电子背散射衍射(EBSD)技术采集 SEM 图像上每个像素的电子衍射花样,从而实现对局部结晶结构的表征。通过对这些衍射花样的处理,可以分析出晶粒结构、相对取向、晶界取向甚至局部应力应变。这样可以在器件性能与结构之间建立关联,而这对于理解金属化器件间互连和硅通孔的导电性十分有用。与 EDS 技术联用后,材料的相可以确定,而不仅是其结构或元素组成。Symmetry EBSD 是第一个基于 CMOS 的探测器,与其他 EBSD 相机相比,速度和灵敏度都更高。因此,用户能够在更短时间内收集更高质量的数据,从而提高生产率。
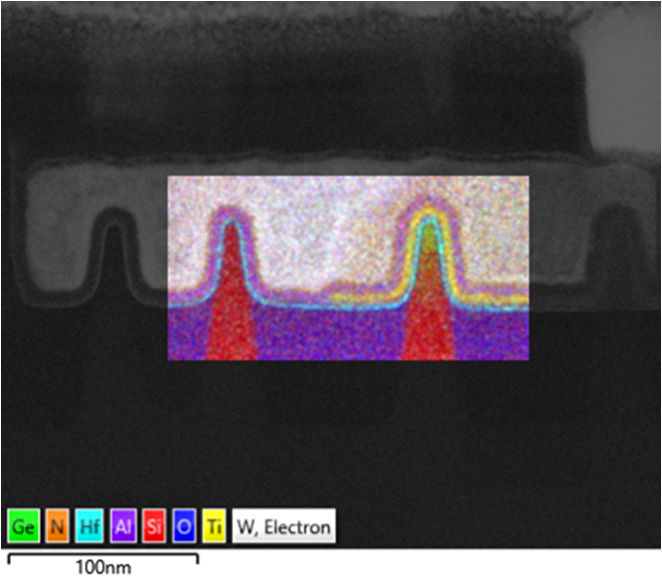


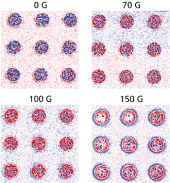
对于数据存储行业,了解磁盘介质的纳米级磁学特性对于终端设备中的性能至关重要。磁力显微镜(MFM)可以对磁盘或其他磁性设备的磁畴结构直接成像。无论是在磁记录位的分析中,还是在传感器读/写信息的过程中,带有可变磁场模块(VFM)的 MFP-3D Infinity 可以对最具挑战性的样本进行精确分析。
MFM还可以与压电显微镜(PFM)一起用于分析多铁基复合材料的磁电耦合特征。这些材料可用于电场和磁场可调谐信号处理装置中,因而成为研究热点。
基于蓝光驱动的轻敲模式大大提高测量数据的可重复性。对于半导体行业,表面粗糙度是一个非常重要的指标,直接影响到最终器件的性能。蓝光驱动技术保持无与伦比的稳定成像,探针的磨损降低到可以忽略的程度。即使经过1000幅图成像,测量的表面粗糙度具备高的重复性。
 公安机关备案号31010402003473
公安机关备案号31010402003473